

Filmetrics
反射式光谱薄膜膜厚测量系统
KLA-Filmetrics 膜厚测量系统利用光谱反射技术实现薄膜厚度的精准测量,
其测量范围从nm-mm ,可实现基本上所有光滑的、半透明的或低吸收系数
的薄膜都可以测绘,如光刻胶、氧化物、 硅或者其他半导体膜、有机薄膜、
导电透明薄膜等膜厚精准测量,被广泛应用于半导体、微电子、 生物医学
等领域。

I 如何测量膜厚

反射率R为与材料n&k、 厚度d以及波长有关的函数,已知n值时,经过测
量可得R曲线,从而求得厚度d。
I 我们测量需要什么?
■ 材料 :全都是至少有部分透明的薄膜,加上所有的半导体(透明或不透明)。
薄膜在外观上至少要有某种程度的光泽。
■ 厚度范围:我们能测量从 nm 到 mm 的厚度。
■ 可测量的层数: 我们通常能够测量某个薄膜堆内的最多三层独立薄膜。
在某些情况下,我们能够测量到几十层。
■ 基板材料:如果薄膜位于粗糙基板(其中包括大多数金属)上的话, 一般不能
测量薄膜的折射率。 此外,粗糙基板还将zui低的可测量薄膜厚度限制为大约50nm。
■ 所需的信息:我们必须知道目前存在所有薄膜的分类、特征和标称厚度,
不管它们是否有待于测量。
I 我们可以测量什么?

I 如何测量?

Filmetrics 产品线
I F10 系列-低成本的薄膜测量专用仪器

I F20 系列-高性价比单点薄膜测量系统

不同的F20仪器主要是根据波长范围来加以区分的。标准的F20 是我们最为普遍的产品。
较短的波长(例如 F20-UV) 一般用于测量较薄的薄膜,而较长的波长则可以用来测量更厚、
更不平整以及更不透明的薄膜。

I F30 系列-在线监控工具
用 F30 光谱反射率系统实时测量沉积速率、沉积层厚度、光学常数(n 和 k 值)和半导体以及
电介质层的均匀性,是监控薄膜沉积最强有力的工具。
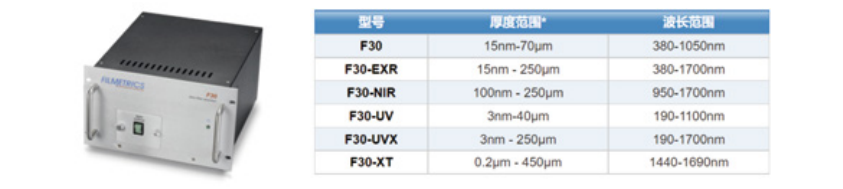
I F3-sX 系列-毫米级膜厚测量的选择

I F40 系列-显微镜制式膜厚测量系统

I F50/F54/F60 系列-自动膜厚测量系统

不同的 F50 仪器是根据波长范围来加以区分的。标准的 F50 是很受欢迎的产品。一般较短
的波长(例如 F50-UV) 可用于测量较薄的薄膜,而较长的波长则可以用来测量更厚、更不
平整以及更不透明的薄膜。

Filmetrics 应用案例
I 铟锡氧化物与透明导电氧化物
液晶显示器,有机发光二极管变异体,以及绝大多数平面显示器技术都依靠透明导电氧化物
(TCO) 来传输电流,并作每个发光元素的阳极。和任何薄膜工艺一样,了解组成显示器各层
物质的 厚度至关重要。对于液晶显示器而言,就需要有测量聚酰亚胺和液晶层厚度的方法,
对有机发光二 极管而言,则需要测量发光、电注入和封装层的厚度。
在测量任何多个层次的时候,诸如光谱反射率和椭偏仪之类的光学技术需要测量或建模估算
每 一个层次的厚度和光学常数(反射率和 k 值)。
■ Filmetrics 的优势
Filmetrics 已经开发出简便易行而经济有效的方法,利用光谱反射率精准测量氧化铟锡。
将新型的氧化铟锡模式和 F20-EXR, 很宽的400-170Onm 波长相结合,从而实现氧化铟锡
可靠的“一键” 分析。氧化铟锡层的特性一旦得到确定,剩余显示层分析的关键就解决了。
不管您参与对显示器的基础研究还是制造,Filmetrics 都能够提供您所需要的..
■测量液晶层 ■ 测量有机发光二极管层
-聚酰亚胺、硬涂层、液晶、间隙 -发光、电注入、缓冲垫、封装
对于空白样品,我们建议使用F20 系列仪器。对于图案片,Filmetrics 的 F40 用于测量薄膜厚
度已经找到了显示器应用广泛使用。
此案例中,我们成功地测量了蓝宝石和硼硅玻璃基底上铟锡氧化物薄膜厚度。

I 电介质
成千上万的电解质薄膜被用于光学,半导体以及其它数十个行业,而 Filmetrics 的仪器几乎可
以测量所有的薄膜。常见的电介质有:
二氧化硅一最简单的材料之一,主要是因为它在大部分光谱上的无吸收性(k=0), 而且非常接近
化学计量(就是说,硅:氧非常接近1:2)。受热生长的二氧化硅对光谱反应规范,通常被用来做
厚度和折射率标准。Filmetrics能测量3nm 到 1mm 的二氧化硅厚度。
氮化硅一对此薄膜的测量比很多电介质困难,因为硅:氮比率通常不是3:4,而且折射率一般要
与薄膜厚度同时测量。更麻烦的是,氧常常渗入薄膜,生成一定程度的氮氧化硅,增大测量难度。
■测量范例
氮化硅薄膜作为电介质,钝化层,或掩膜材料被广泛应用于半导体产业。这个案例中,我们用
F20-UVX 成功地测量了硅基底上氮化硅薄膜的厚度,折射率,和消光系数。有趣的事,氮化硅
薄膜 的光学性质与薄膜的分子当量紧密相关。使用 Filmetrics专有的氮化硅扩散模型,F20-UVX
可以很 容易地测量氮化硅薄膜的厚度和光学性质,不管他们是富硅,贫硅,还是分子当量。

I SU-8 光刻胶厚度测量
MEMS 和其他器件的开发和制造中的挑战之一是测量 SU-8 和其他光刻胶的厚度。虽然简单快速,
但旋涂 SU-8 可能是产生所需厚度的不准确方法。由于曝光时间取决于抗蚀剂厚度,因此必须进
行精准测量。此外,由于正性和负性光刻胶可以结合使用来创建复杂的多层结构,因此了解每一 层
的厚度变得非常重要。
■Filmetrics 的优势
Filmetrics 提供一系列的和测绘系统来测量3nm 到 1mm 的单层、多层、以及单独的光刻胶薄膜。
所有的Filmetrics 型号都能通过精准的光谱反射建模来测量厚度(和折射率)。专有的算法使得“一键”
分析成为可能,通常在一秒钟内即可得到结果。
